Accueil \ Laboratoires de recherche \ IJCLab - Laboratoire de Physique des 2 Infinis Irène Joliot-Curie \ Pôles de Recherche \ Physique des Accélérateurs \ Plateforme Vide & Surfaces / MAVERICS - MATERIALS-VACUUM-SUPERCONDUCTING-RF \
Spectrométrie de masse des ions secondaires (SIMS)
12/21
Tailles de photo
✔ M - moyen (792 x 444)✔ L - grand (1008 x 566)
✔ XL - très grand (1224 x 687)
✔ XXL - énorme (1656 x 930)
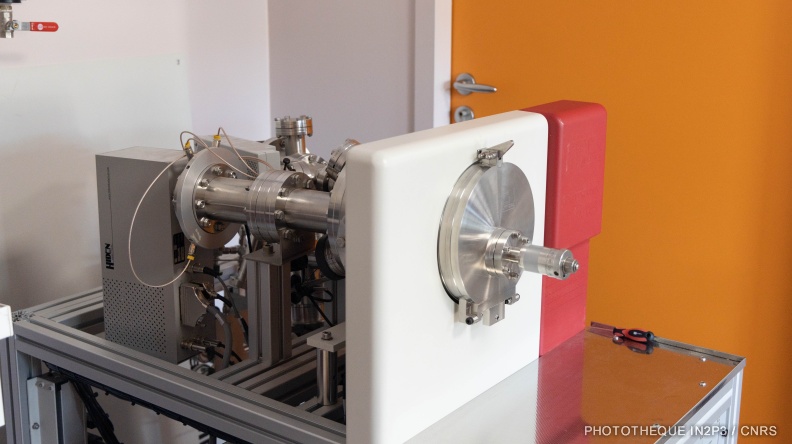
Spectrométrie de masse des ions secondaires (SIMS)
Modèle : Compact SIMS d’Hiden Analytical.
Le SIMS « statique »
– Intensité faible des ions incidents ( 1nA/cm2) pulvérisation faible.
– Spectre surface avec m compris entre 0 et 300 amu.
– Analyse chimique (qq nm).
Le SIMS « dynamique »
– Intensité importante des ions incidents ( 1mA/cm2) pulvérisation forte (> 10µm/h).
– Analyse élémentaire en fonction de la profondeur.
– Méthode destructrice.
Faisceau :
– Energie/courant:1 to 5 keV / up to 400nA
– Gaz: Oxygène ou Argon
– Taille faisceau : < 50μm (imagerie) ,80 μm en profilométrie
– Résolution : 2 nm
– Détection qq ppm at
- Auteur
- Dominique Longieras / IJCLab
- Créée le
- Mardi 21 Février 2023
- Ajoutée le
- Mercredi 22 Novembre 2023
- Dimensions
- 6508*3656
- Fichier
- 1_c_p_spectrometrie_masse_ions_secondaires_SIMS_00235.jpg
- Poids
- 2488 Ko
- Mots-clés
- campus d'Orsay, CNRS, faisceaux, IJCLab, ions, laboratoire des 2 infinis irene joliot-curie, plateforme Vide & Surfaces, spectrométrie
- Albums
- Visites
- 1435
- Make
- Canon
- Model
- Canon EOS R
- ExposureTime
- 1/80
- FocalLength
- 43/1
- FNumber
- 45/10
- ExposureBiasValue
- 0/1
- ISOSpeedRatings
- 1000
- DateTimeOriginal
- 2023:02:21 14:51:04
- ExposureProgram
- 4
- Flash
- 0
- MeteringMode
- 3
- iptc_Date_Created
- 20230221
- iptc_Time_Created
- 145104+0100
- iptc_By_line
- com-IJCLab